高密度ラジカル源装置
・MBEの成膜速度を向上させるため、従来のラジカル源より、高密度のNラジカルを供給します。
・同じく名古屋大学と共同開発した世界で唯一のラジカル絶対量を定量的に測れる計測器により、発生ラジカル量が製品スペックで保証された世界で唯一のラジカル源です。
・不純物が発生しないように設計されたラジカル源は、GaNの高品質結晶成長を維持したまま、従来よりも高速成長を実現します。
・パワーデバイス、LED向けに最適なラジカル源です。
・Oラジカルも生成可能ですので、酸化物への展開も可能です。

特徴
・イオン除去、電子除去機構付
・H,N,O高密度ラジカル発生
・ICF114フランジ取付
・ガス供給外部制御機能付
・プロセスチャンバー圧力調整用オリフィス付構成
・原子状ラジカル発生源
・ヘッド一体型マッチングボックス
・ガス供給装置
・フィードバック制御(オプション)
 ラジカルモニター RadiMo
ラジカルモニター RadiMo
プロセスで使える超小型ラジカル絶対密度計測装置
各種プラズマ技術を用いて行うエッチング・表面処理・薄膜作製プロセス時において、プラズマ中に生成され、これらプロセスに重要な役割を果す各種原子状ラジカルの絶対密度を計測し、プロセスへのフィードバックを可能としたモニタリング装置です。

仕様
【ラジカル種】 H/N/O
【計測方式】 真空紫外吸収分光
【検出限界】 1010個/cm³以上
【測定方式】 プローブ方式
【取付け方法】 ICF70フランジ特徴
・水素、窒素、酸素の原子状ラジカルを真空紫外吸収分光法を用いてダイレクトに計測し
プロセスにフィードバックが可能
・ICF70フランジに取付可能
・各種プラズマ装置に取付可能(EBEP処理装置, CCPエッチング/CVD, Catプロセス/CVD, ICPエッチング/CVD 等)
・真空排気系一体制御型モニタリングシステム等、システム構成はお客様のニーズに対応構成
・ラジカルモニターヘッド
・制御電源
・小型真空紫外分光器
波長帯域:120~170nm
・真空排気系
・データ解析装置概略図
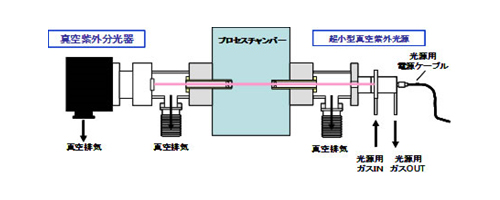
※その他各種ラジカル計測およびラジカル応用装置についてはお問い合せください。
F-RadiMo

仕様
【原理】
真空紫外吸収分光法
【計測対象ラジカル】
基底状態(2p5 2P)フッ素ラジカル
【プローブ光】
波長 95.6nm(2p4 3s 2P-2p5 2P)
【計測密度範囲】
3.8×1010~1.1×1013[㎝-3]
(理論値・・・吸収率:5%~95%、吸収長150mm、ラジカル温度400Kの場合)特徴
・吸収分光法により基底状態のフッ素ラジカル絶対密度の計測ができます。
・光源から放射されるプローブ光のスペクトルは高精度にキャリブレーションされています。
・発光、非発光プラズマのどちらでも計測することができます。
・絶対密度算出のため校正が必要ありません。
・F-RadiMoはプロセス装置のポートに取り付けることにより計測可能になります。応用
・プラズマ発生ラジカル計測
・エッチング装置
・表面処理装置
・チャンバークリーニング
・ダウンフロープラズマ発生ラジカル計測
・アフターグロープラズマ発生ラジカル測定
小型VUV分光器

仕様
【波長帯域】
115-200nm
【理論波長分解能】
<0.4nm(スリット幅0.1mm)
【検出器】
ソーラーブラインド光電子増倍管
【回折格子】
4968line/mm【使用圧力】
<10E-3 Torr
【サイズ(取り付けフランジ、突起部を除く】
250㎜(W), 230mm(D), 150mm(H)制御ボックス
・波長走査用ドライバ
・光電子増倍管用高電圧電光源
・光電子増倍管用プリアンプ→19インチラック対応の制御ボックスに収められています。応用
・RadiMo用検出器
・真空紫外吸収分光用分光器
・真空紫外発光分光用分光器
μ-AP型大気圧非平衡プラズマ装置
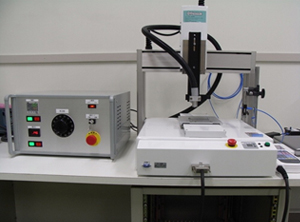
特徴
【高電子密度】 1015個/cm³
【供給電圧】 AC100V駆動
【プラズマガス】 Ar、窒素、酸素 他
【小型簡便】
【微小スポットプラズマ】応用例
・親水
・表面クリーニング
・接合強度向上
・有機化合物合成
・減菌・殺菌
・カーボンナノ成長
大気圧非平衡プラズマ表面照射による親水性の変化

※各種大気圧プラズマ装置に関するご要望に対応させていただきます。
ナノ粒子製造
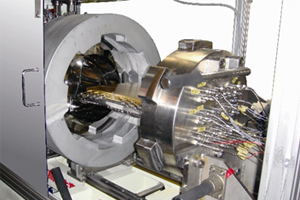
ナノ粒子製造・担持用超臨界装置
特徴
【簡単な開閉】
超臨界装置は、高圧状態で生成されるため厳重な圧力封入が不可欠です。
そのために簡易に開けしますることが難しく非常に面倒です。NUシステムの超臨界装置は、蓋部に特殊クラッチドアを採用し、ハンドル部の操作のみで簡単に開閉を可能にしました。
【恒温から低音まで】
試験体―製品の形状に合わせマウント(ベース)の形状は任意に制作できます。また、マウントに直接ヒーターを取りつけ製品に直接加熱することができ、外部温調器により超臨界雰囲気を温度可変することも可能です。
【簡単な自動制御】
使用する流体に応じて、必要な圧力・温度・時間を入力するだけで自動的に超臨界を生成し様々な処理を行い排出を行いますので、ユーザーが行うのは試験体・製品をマウントするだけで簡単に超臨界処理できます。量産型 NA-48 基本仕様
【内容量】メイン容器 48L, サブ容器 7L
【使用圧力】MAX 9.9MPa
【使用温度】MAX 200℃
・高圧ガス認定品小型 NE-07 基本仕様
【内容量】メイン容器 1L, サブ容器 0.5L
【使用圧力】MAX 9.9MPa
【使用温度】MAX 200℃
高圧ガス認定品
 高精度スーパーコンティニューム光源
高精度スーパーコンティニューム光源

高精度スーパーコンティニューム光源
特徴
・強度雑音が理想的なレーザーと同等レベル
・驚異の超平坦性
・長時間安定
・光通信帯を全てカバー
・理想的な光周波数コム仕様
【スペクトル帯域】1300-2000 nm
【平均出力】40 mW
【スペクトル密度】-12 dBm/nm
【波長平坦度】<±1 dB
【強度雑音】-160 dB/Hz @ 1MHz
構成
・光源本体
・電子制御部
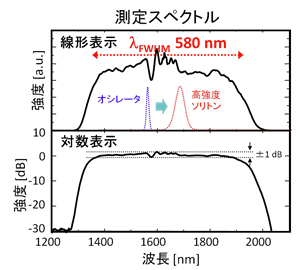
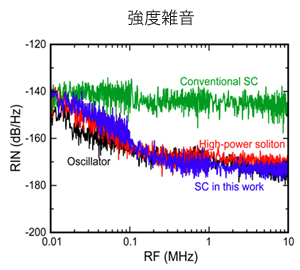
ナノカーボン堆積装置
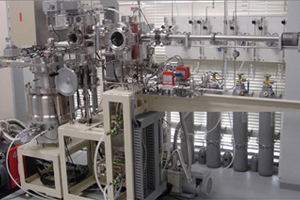
ナノカーボン堆積装置

大面積ナノカーボン堆積装置

PNナノカーボン堆積装置

ハイパーナノコーティング装置

CCP型プラズマエッチング装置

特徴
・停電し温度、高密度プラズマが得られる60MHzパワーを上部電極に印加、イオンエネルギーを高精度に制御するため2MHzを㈱電極に印加(オプション)
・常に最適なエッチングプロセス条件が維持されるシーケンスプログラムを内蔵。エッチング処理ごとのクリーニング処理(O2)により、電極やチャンバー壁についてフロン系膜を除去
適用例
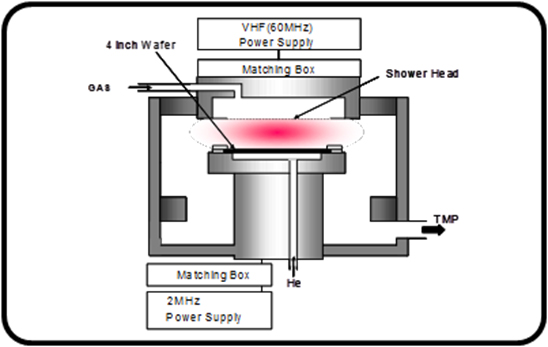
EBEP(電子ビーム励起プラズマ源)概略図
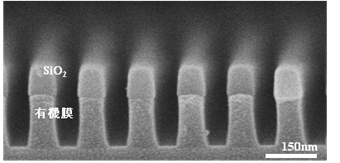
EBEP処理装置
従来のプラズマ発生方法では、外部から電力を導入するため、プラズマガスの電離によって生じた電子のみがプラズマ中に存在しています。そのためプラズマパラメータはガス流量・圧力、および外部電力の種類等に依存していました。これに対しEBEPは制御された電子ビームをプラズマ反応空間中に直接打ち込むことにより、プラズマガスを電離させます。これにより、プラズマパラメータを直接的に制御することができます。

適用例
・高速窒化処理(難窒化材にも適用可)
・機能性膜(BN膜等)
・酸化膜エッチング
・カーボン膜(DLC,ダイヤモンド膜)
・ナノカーボン膜(CNT,CNW)
・Si膜
・酸化膜 他EBEP(電子ビーム励起プラズマ源)概略図
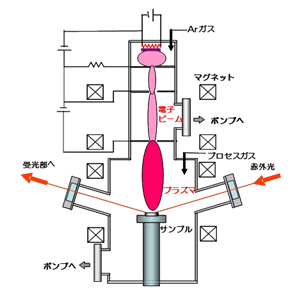
※電子ビーム励起プラズマ源は、(独)理化学研究所の特許の実施権を取得して改良を加え、装置化したものです。
基盤温度モニター
特徴
・基盤そのものを測定。
※接触型はプローブの温度が表示されるため測定対象物と熱平衡でない場合は正確な温度が測れない
・高速応答
・多層基板の各層の温度を個別に測定可能
・薄膜の膜厚と基板の温度の同時測定が可能
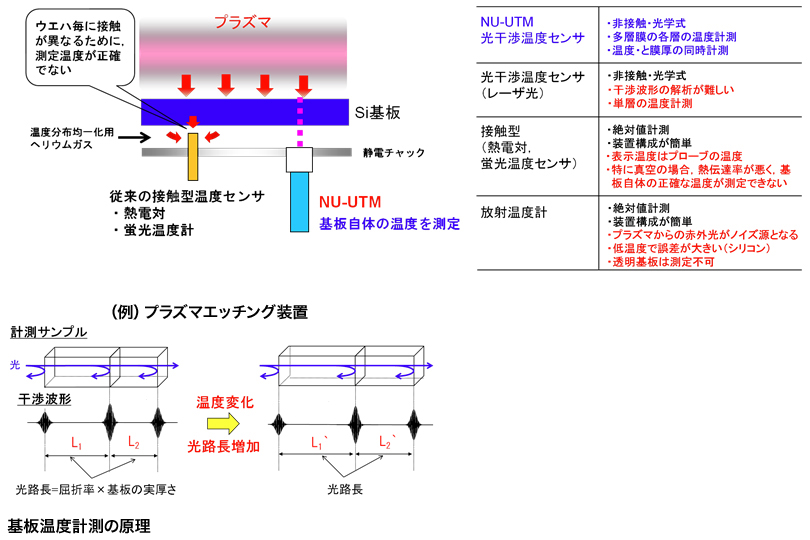
お問い合わせはこちら
TEL:052-933-1320





